포토 소재
포토레지스트(Photo Resist)
광 및 방사선 에너지에 노출시키면 현상액에 대한 용해도 변화가 발생하여 이미지 패턴을 형성하는 재료이며, 고분자, 감광제, 첨가제, 용제로 구성되어 있는 액상재료 입니다.

포토레지스트의 종류
- 광원의 파장에 따라 I-line( 약 365nm), KrF(248nm), ArF(193nm), EUV(13.5nm)로 나누어지면 파장의 선 폭이 좁을수록 미세회로를 그릴 수 있습니다.
- 빛에 노광 되는 영역이 녹는 Positive PR과 노광 되지 않는 영역이 녹는 Negative PR로 구분할 수 있습니다.
- SKMP는 DRAM 용과 NAND 용 반도체 생산 시 포토리소그래피 공정에 사용되는 물질로써 ArF Imm. PR부터 후공정용 고두께 Bump PR까지 다양한 제품군을 보유하고 있으며 반도체 Tech 고도화 및 미세화에 따른 EUV PR 제품 개발을 진행하고 있습니다.
포토레지스트(PR) 종류와 특성

-
포지티브 PR
- 포지티브 PR
- 기판
- (←)PR코팅(→)
-
네거티브 PR
- 네거티브 PR
- 기판
-
- 빛(노광)
- (←)포토마스크(→)
-
- 빛(노광)
- 현상
- 패턴화된 PR
반사방지막(BARC)
노광 공정 중 발생하는 Substrate로부터 빛의 산란과 반사를 억제하여 Pattern profil에 대한 손실을 최소화하는 Material입니다. SKMP의 BARC는 BARC 제품은 ArF Imm. BARC부터 KrF BARC까지 코팅성이 우수한 제품군을 보유하고 있으며 높은 굴절률(n)을 갖고 있어서 최소한의 두께로도 물성 구현이 가능합니다.
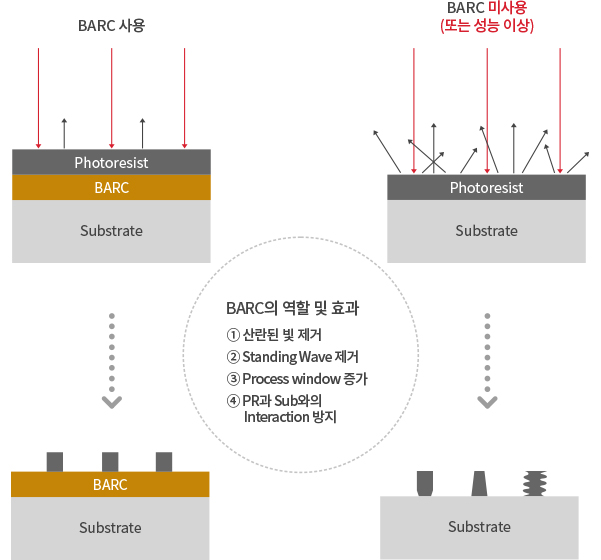
-
BARC 사용
- Photoresist
- BARC
- Substrate
→
- BARC
- Substrate
-
BARC의 역할 및 효과
- 산란된 빛 제거
- Standing Wave 제거
- Process window 증가
- PR과 Sub와의 Interaction 방지
-
BARC 미사용(또는 성능 이상)
- Photoresist
- Substrate
→
- Substrate
하드마스크(SOC)
반도체의 고집적화에 따라 PR의 두께가 점점 얇아지고 패턴의 크기가 작아짐에 따라 PR 패턴의 쓰러짐 현상이 발생하게 됩니다.
때문에 PR 패턴을 이용하여 피식 각층을 식각할 수 없게 되어 PR과 피식 각층 사이에 식각 내성이 강한 대표적 물질이 하드 마스크(SOC)입니다.
강한 식각 내성 및 평탄화 특성을 갖는 SKMP의 SOC 제품은 400Å의 제품군부터 3㎛ 두께 구현이 가능한 제품군까지 다양하게 보유하고
고객사 및 반도체 기술 발달에 따라 공정 특성에 맞는 우수한 SOC를 개발하고 있습니다.

-
- Substrate
Photoresist 두께를 낮춰 패턴 쓰러짐 현상 방지
- 에치(→)
-
- Substrate
식각 공정 시 원하는 깊이의 패턴을 얻지 못함
Hardmask 도입
-
- Photoresist
- Hardmask
- Substrate
- 노광현상(→)
-
- Hardmask
- Substrate
- 에치(→)
-
- Substrate
- 에치(→)
-
원하는 크기와 깊이의 패턴 완성
- Substrate