フォト素材
フォトレジスト
光や放射線エネルギーに露出されると現像液に対する溶解度の変化が生じて画像パターンを形成する材料。高分子、感光材、添加剤、溶剤から構成される液状材料です。

フォトレジストの種類
- 光源の波長によってI-line(約365nm)、KrF(248nm)、ArF(193nm)、EUV(13.5nm)に分けられ、波長の線幅が狭いほど微細な回路を描くことができます。
- 露光された領域が溶けるポジティブ型PRと露光されなかった領域が溶けるネガティブ型PRに区分されます。
- SKMPはDRAM用とNAND用の半導体を製造する時にフォトリソグラフィ工程で使用される物質で、ArF Imm. PRから後工程用の厚膜Bump PRまで多様な製品群を有しており、半導体技術の高度化と微細化に伴いEUV PR製品の開発を行っています。
フォトレジスト(PR)種類と特性
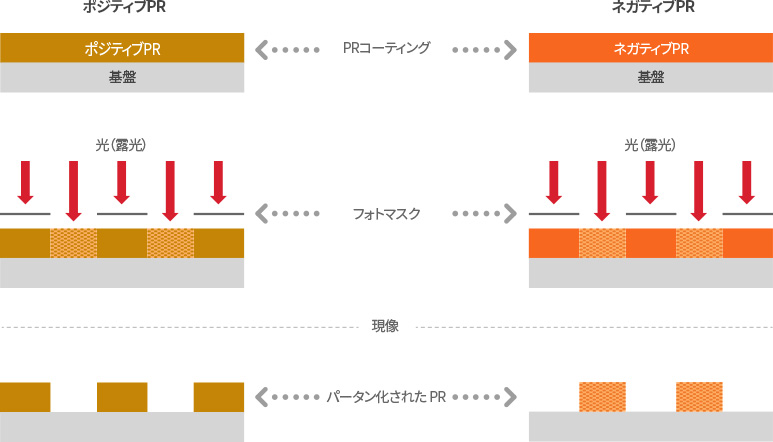
反射防止膜(BARC)
露光工程中に発生する基板(Substrate)からの光の散乱と反射を抑制し、パターンプロフィルの損失を小化する材料です。SKMPのBARCはBARC 製品はArF Imm. BARCからKrF BARCまでコーティング性に優れた製品群を有しており、高屈折率(n)を持っているため最小限の厚さでも物性を実現可能です。
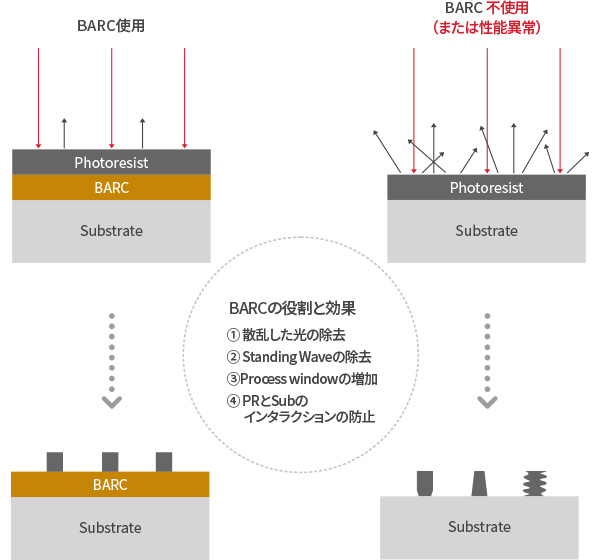
ハードマスク(SOC)
半導体の高集積化に伴い、PRは薄くなり、パターンが小さくなるにつれて、PRパターン倒れが起きるようになります。そのため、PRパターンを利用した被食刻層のエッチングができなくなり、PRと被食刻層の間にエッチング耐性の強い代表的な物質がハードマスク(SOC)です。
強いエッチング耐性と平坦化の特性をもつSKMPのSOC製品は、400Åの製品群から厚さ3㎛が実現できる製品群まで多種多様なものを保有しており、顧客会社と半導体技術の発達に歩調を合わせ、工程の特性に合った優秀なSOCを開発しています。